NESY031C january 2023 – april 2023 LMQ61460-Q1 , TPS54319 , TPS62088 , TPS82671 , UCC12040 , UCC12050
封裝熱創新
積體電路 (IC) 封裝的直接散熱能力會影響功率密度。如前面提到,隨著封裝尺寸持續縮減,此問題也變得越來越重要。此外在傳統電源轉換器中,半導體裝置常成為解決方案的熱門選項,在 Rsp 也快速縮減的情況下更是如此。
TI 在開發與採用 HotRod™ 封裝上投入大量資源,並以覆晶式封裝取代傳統焊線型四方平面無引腳封裝 (QFN)。圖 9 和圖 10 顯示 HotRod QFN 如何能免除使用焊線,同時維持像 QFN 的體積。此方式可大幅降低傳統覆晶式封裝中的寄生迴路電感,並可維持 QFN 封裝熱性能的部分優點。HotRod QFN 包含引線鍵合支架與晶粒間的互連。
 圖 9 採用暴露焊盤的標準焊線 QFN 封裝。
圖 9 採用暴露焊盤的標準焊線 QFN 封裝。 圖 10 HotRod 互連封裝 (導線上覆晶接合) QFN 封裝。
圖 10 HotRod 互連封裝 (導線上覆晶接合) QFN 封裝。HotRod 封裝所面臨的其中一個挑戰,是大型黏晶粒板 (DAP) 的建置過程變得更困難,但 DAP 在改善封裝熱性能上有非常大的幫助。為了克服此挑戰,TI 最近針對 HotRod QFN 進行強化,除了保留其現有優勢,同時讓封裝能夠採用大型 DAP。
圖 11和圖 12 圖 14 向展示 4-A LM60440 同步轉換器,其包括的這些技術增強功能,可提高散熱性能。您可看到其體積有助於封裝中央使用大型 DAP。與前代相比,此 DAP 具備 15% 溫度上升優勢。您可以在我們的 Analog Design Journal 文章「以小型 DC/DC 轉換器進行設計」中閱讀有關這些封裝演進的詳細資訊: HotRod™ QFN 與強化的 HotRod™ QFN 封裝.
 圖 11 具大型 DAP 的強化式 HotRod QFN。
圖 11 具大型 DAP 的強化式 HotRod QFN。 圖 12 採用強化式 HotRod QFN 的 LM60440 針腳配置。
圖 12 採用強化式 HotRod QFN 的 LM60440 針腳配置。 圖 13 傳統 HotRod 封裝的熱性能。
圖 13 傳統 HotRod 封裝的熱性能。 圖 14 採用強化式 HotRod QFN 封裝且具 DAP 的 LM60440 熱性能,平均溫度可降至 71.1°C。
圖 14 採用強化式 HotRod QFN 封裝且具 DAP 的 LM60440 熱性能,平均溫度可降至 71.1°C。此外,許多設計人員偏好採用小型電晶體 (SOT) 表面黏著封裝,因為這種封裝成本較低,而其針腳引線的組裝方式也較為簡單。TI 已將改良製程技術與電路 IP 與 SOT-563 封裝配對,使小巧的雙列針腳配置能符合更高電流密度的需求。 TPS566242 3-V 至 16-V 同步降壓轉換器是最近的範例之一。本裝置採用 1.6 mm x 1.6 mm SOT-563 (6-針) 板上配置,支援 98% 工作週期下高達 6 A 的連續電流。
同樣的,採用晶圓級晶片尺寸封裝 (WCSP) 時,多數熱能會從凸塊直接向下傳導至 PCB。WCSP 中的凸塊面積越大,熱性能就越好。TI 最近開發並推出 PowerCSP™ 封裝,旨在以大型錫棒取代 WCSP 中的部分傳統電路凸塊,進而提升封裝熱與電性能。圖 15 是在 TPS62088 中實作此技術的範例。圖 15 顯示標準 WCSP,而 圖 16 則展示採用 PowerCSP 封裝的相同裝置。在系統沒有任何其他變化的情況下,溫度上升程度降低約 5%。

| VIN = 5 V | VOUT = 1.8 V |
| IOUT = 3 A | TA = 25°C |
| 量測點:Bx1 |
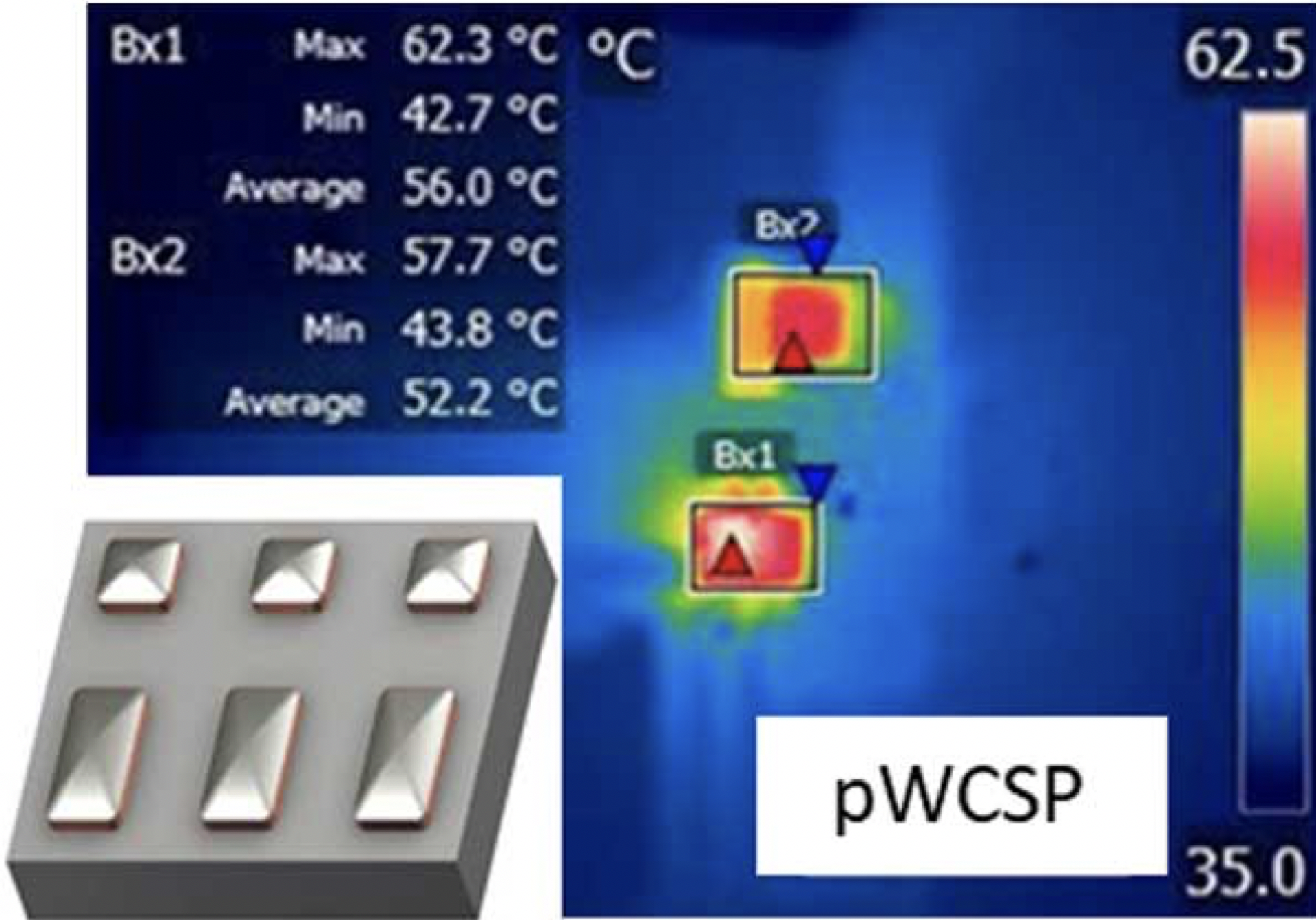
| VIN = 5 V | VOUT = 1.8 V |
| IOUT = 3 A | TA = 25°C |
| 量測點:Bx1 |